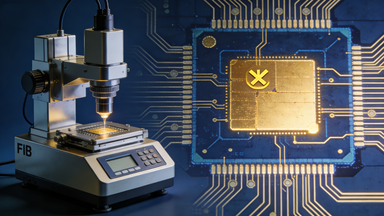
在先进制程节点不断推进至2nm时代,集成电路结构日益复杂,特征尺寸缩小带来的缺陷如栅氧击穿、金属虚空、电迁移等越来越隐蔽。传统光学或SEM观察已难以满足原子级失效定位需求。聚焦离子束(FIB)和透射电子显微镜(TEM)相结合的技术已成为集成电路失效分析(FA)的金标准,能实现纳米级精准制样和高分辨率成像,帮助工程师快速锁定根因、优化工艺。根据2025年行业报告,超过80%的先进IC失效分析依赖FIB-TEM流程,这一技术直接提升了芯片良率和可靠性。
FIB技术原理与作用
聚焦离子束(FIB)使用镓离子束(Ga+)对样品进行精密铣削、沉积和成像,主要作用包括:
- 精准截面制备:纳米级定位切割,暴露内部结构。
- 电路编辑:局部金属沉积/切断,用于调试。
- 二次电子成像:结合SEM功能观察形貌。
FIB分辨率可达5nm以下,适用于3D封装、FinFET等复杂结构。
TEM技术原理与优势
透射电子显微镜(TEM)利用高能电子束透射超薄样品(<100nm),提供原子级分辨率成像。
关键优势:
- 高分辨率HRTEM:观察晶格缺陷、界面原子排列。
- 衍射分析:鉴定材料相结构。
- 能谱结合(EDS/EELS):元素分布映射。
TEM是验证纳米级缺陷(如位错、掺杂不均)的终极工具。
FIB与TEM对比
| 项目 | FIB | TEM |
|---|---|---|
| 分辨率 | 5~10nm | <0.1nm(原子级) |
| 样品要求 | 无需超薄 | 需<100nm电子透明薄片 |
| 主要功能 | 制样、截面成像、编辑 | 高分辨结构、成分分析 |
| 分析深度 | 表面至微米级 | 原子尺度缺陷 |
| 适用阶段 | 初步定位、快速截面 | 终极验证、根因分析 |
二者互补:FIB负责精准制样,TEM提供深度洞察。
典型应用流程
集成电路失效分析中FIB-TEM标准流程:
- 故障定位:电学测试+热斑/EMMI锁定区域。
- FIB制样:保护层沉积 → 粗铣 → 精细减薄 → Lift-out提取。
- TEM观察:装载薄片 → HRTEM成像 → EDS映射 → 衍射分析。
- 数据解读:结合工艺判断根因(如界面扩散、晶界缺陷)。
常见案例:栅氧击穿分析中,FIB精准截取疑似点,TEM揭示氧化层局部减薄或污染物。
应用案例
- 金属虚空:FIB截面显示互联层空洞,TEM确认电迁移引起晶界分离。
- 栅氧缺陷:TEM高分辨像观察到原子级针孔,导致漏电。
- 先进封装:3D堆叠TSV接口,FIB-TEM揭示Cu泵出和界面分层。
FIB与TEM在集成电路失效分析中的应用是实现根因溯源、工艺优化的核心技术组合,通过纳米级精准制样和原子级成像,帮助企业快速解决复杂失效问题,提升先进节点芯片的可靠性和竞争力。
深圳汇策作为专业第三方检测机构,提供集成电路失效分析服务,配备先进双束FIB(DB-FIB)、PFIB等离子体聚焦离子束及高分辨TEM系统,支持晶圆级/封装级精准FIB制样、TEM拍摄分析及EDS/EELS成分表征。我们为客户提供高效、专业的FA解决方案,助力根因定位与可靠性提升。





