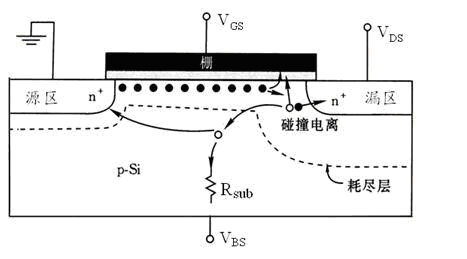
在半导体芯片的长期使用中,大家可能会发现芯片变慢了,或者开启电压变了。这很可能是热载流子注入(Hot Carrier Injection, HCI)在作怪。虽然名字里带“热”,但它在低温下反而更严重。它是现代微缩工艺(尤其是短沟道器件)中不可忽视的可靠性问题。
什么是“热载流子”?
在MOSFET的沟道中,当漏极电压(Vds)很高时,漏端附近的电场会变得极强。
电子在强电场中加速,获得了极高的动能,变成了“热电子”(Hot Electron)。
这些“热电子”能量太高,甚至能冲破势垒,撞进脆弱的栅极氧化层(Gate Oxide),造成损伤。
HCI带来的危害
一旦热电子陷在氧化层里或在界面产生缺陷,就会永久性地改变器件参数:
- 阈值电压 (Vth) 漂移: 通常Vth会升高,导致管子更难开启。
- 饱和电流 (Idsat) 下降: 沟道迁移率变差,驱动能力变弱,导致电路速度变慢。
- 跨导 (Gm) 降低: 控制能力下降。
HCI测试方法与条件
为了在短时间内模拟几年的老化,HCI测试通常采用电压加速。
- 最恶劣条件: 对于NMOS,通常发生在 $V_{gs} \approx V_{ds} / 2$ 时(此时衬底电流 Isub 最大)。
- 温度选择: HCI具有负温度系数。与一般老化不同,低温(如-40℃)下电子平均自由程更长,更容易获得高能量。因此HCI通常在常温或低温下测试。
- 判据: 当Vth漂移超过50mV,或Idsat下降超过10%,判定失效。
总结
HCI效应限制了芯片的工作电压上限。通过HCI测试,我们可以绘制出寿命-电压曲线,确定芯片的“安全工作电压区”,在性能与寿命之间找到平衡点。
上海德垲拥有先进的半导体可靠性分析系统,支持晶圆级(Wafer Level)的HCI、NBTI/PBTI等退化机理测试。我们能为先进制程及功率MOSFET提供精准的寿命预测模型,帮助设计人员优化LDD(轻掺杂漏)结构,提升抗HCI能力。





