FIB与TEM在集成电路失效分析中的应用
FIB与TEM在集成电路失效分析中的应用详解,包括原理、对比、流程及案例。了解如何利用聚焦离子束和透射电镜实现纳米级缺陷定位与根因分析。
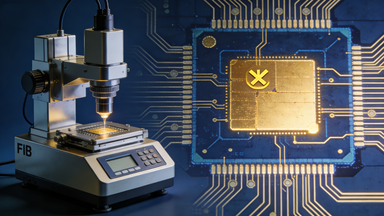
FIB与TEM在集成电路失效分析中的应用详解,包括原理、对比、流程及案例。了解如何利用聚焦离子束和透射电镜实现纳米级缺陷定位与根因分析。

光电子器件失效分析结合光学与电学测试,定位光电转换效率下降与暗电流增加等故障根因。

金属与塑料件断口失效分析通过SEM观察与力学测试,揭示疲劳、过载或腐蚀导致的断裂机制。

功率器件失效分析聚焦热应力、键合与材料退化,助力高功率模块可靠性提升。

PCB板材及焊点失效分析评估虚焊、裂纹与分层问题,提供工艺优化与可靠性改进方案。

电子元器件失效分析结合电气测试与微观表征,快速定位故障根因并提出改进措施。

集成电路失效分析通过分层、显微观察与电学定位,揭示芯片内部缺陷与失效机制。
注意:每日仅限20个名额
广州分公司
地址:广州市黄埔区云埔街源祥路96号弘大商贸创意园5号楼605房
深圳分公司
地址:深圳市坪山区碧岭街道碧岭社区坪山金碧路543号忠诚科技大厦801B
上海分公司
地址:上海市奉贤区星火开发区莲塘路251号8幢
芜湖分公司
地址:安徽省芜湖市镜湖区范罗山街道黄山中路金鼎大厦1411